ホームページ >テクノロジー周辺機器 >IT業界 >関係者によると、インテルは高NA EUVリソグラフィーのパターン品質向上を支援するDSAテクノロジーの導入を検討しているという
関係者によると、インテルは高NA EUVリソグラフィーのパターン品質向上を支援するDSAテクノロジーの導入を検討しているという
- WBOYWBOYWBOYWBOYWBOYWBOYWBOYWBOYWBOYWBOYWBOYWBOYWB転載
- 2024-04-20 08:28:151509ブラウズ
当サイトの4月19日のニュースによると、海外メディアSemiAnaracyとThe Elecは、Intelが将来の高NA EUVリソグラフィノードを支援するために指向性自己組織化DSA技術の導入を検討していると報じた。
DSA は、従来のフォトリソグラフィー (このサイトの注: もう 1 つはナノインプリンティング NIL) を部分的に置き換えることができると考えられている新しいパターニング技術の 1 つであり、キメラ共重合体の分子特性を利用してパターニングを実現します。一般に、単独で使用するよりも、従来のフォトリソグラフィーを支援するのに適していると考えられています。
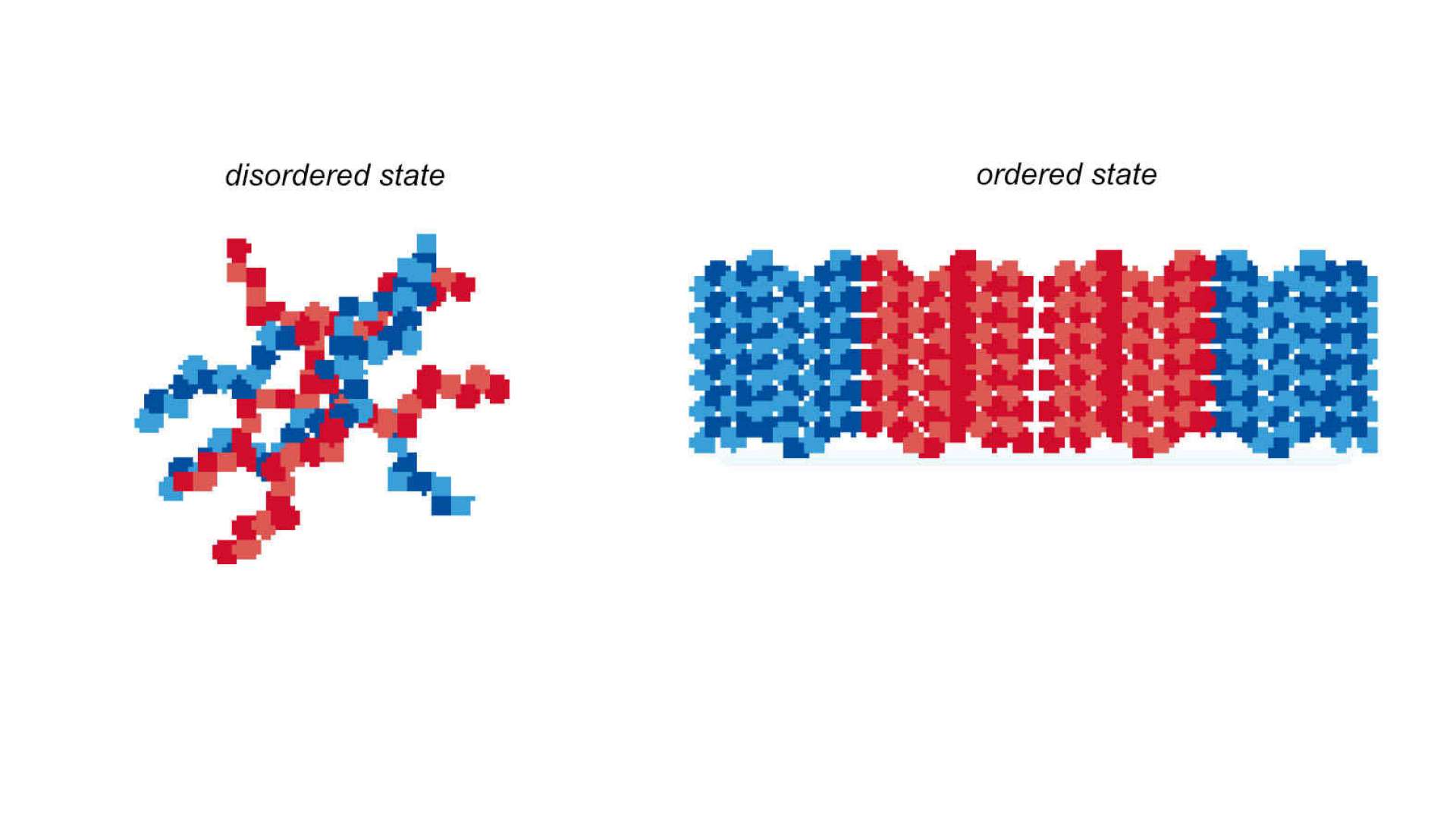
セミアナリシスは、高 NA EUV リソグラフィーが直面する大きな問題は臨界寸法 (CD、半導体プロセスの洗練度を測る重要な指標) の一貫性であると考えています。タイミング照射線量とフォトリソグラフィー装置のウェハスループットとの間の矛盾は、CDの変動につながります。この問題を解決するには、リソグラフィー装置の安定性とリソグラフィー照射量の均一性を向上させる一連の措置を講じる必要があります。
ウェーハ製造工場で限界寸法を確保しながら良好なパターニング効果を得る必要がある場合は、照射線量を増やす必要があります。これにより、リソグラフィープロセスが遅くなり、リソグラフィー装置のウェーハスループットが低下し、ウェーハ製造工場のコスト負担が増加します。
工場がリソグラフィー装置をより高いスループットで実行している場合、照射線量が減少するにつれてリソグラフィーパターンの品質が低下することを意味します。この時点で、DSA 方向性自己組織化技術が機能して、フォトリソグラフィ パターン上のフィーチャ エラーを修復できます。
DSA 指向性自己組織化の導入により、フォトリソグラフィー パターンの品質が向上すると同時に、照射線量を削減し、フォトリソグラフィー マシンのウェーハ スループットを向上させることができます。 これにより、高 NA EUV リソグラフィーのコストが増加します。効果的なセックス。
DSA に加えて、インテルは高 NA EUV リソグラフィーにパターン整形技術を導入することも検討しています。
アプライド マテリアルズは、昨年初めに Centura Sculpta パターン整形システムをリリースしました。このシステムは、ウェハ上の特徴的なパターンを一方向に正確に修正することができ、キーレイヤーのフォトリソグラフィー回数を削減し、フォトリソグラフィーパターンの品質を向上させる効果もあります。
サムスン電子もCentura Sculptaシステムを導入する意向だ。
インテルの研究者マーク・フィリップ氏は、「リソグラフィープロセスの効率を高めるには、それを補うリソグラフィー装置以外の機器の導入が必要だ」と強調する。
以上が関係者によると、インテルは高NA EUVリソグラフィーのパターン品質向上を支援するDSAテクノロジーの導入を検討しているというの詳細内容です。詳細については、PHP 中国語 Web サイトの他の関連記事を参照してください。

