Maison >Périphériques technologiques >Industrie informatique >Samsung a annoncé l'achèvement de la vérification de la technologie du processus d'empilement de liaisons hybrides à 16 couches, qui devrait être largement utilisée dans la mémoire HBM4.
Samsung a annoncé l'achèvement de la vérification de la technologie du processus d'empilement de liaisons hybrides à 16 couches, qui devrait être largement utilisée dans la mémoire HBM4.
- WBOYWBOYWBOYWBOYWBOYWBOYWBOYWBOYWBOYWBOYWBOYWBOYWBavant
- 2024-04-07 21:19:131223parcourir
Selon certaines informations, Dae Woo Kim, directeur de Samsung Electronics, a déclaré que lors de la réunion annuelle 2024 de la Korean Microelectronics and Packaging Society, Samsung Electronics terminerait la vérification de la technologie de mémoire HBM à liaison hybride à 16 couches. Il est rapporté que cette technologie a passé avec succès la vérification technique. Le rapport indique également que cette vérification technique jettera les bases du développement du marché de la mémoire dans les prochaines années.
Dae Woo Kim a déclaré que Samsung Electronics a fabriqué avec succès une mémoire HBM3 empilée à 16 couches basée sur la technologie de liaison hybride L'échantillon de mémoire fonctionne normalement et la technologie de liaison hybride empilée à 16 couches sera utilisée pour la production en série de la mémoire HBM4. à l'avenir.
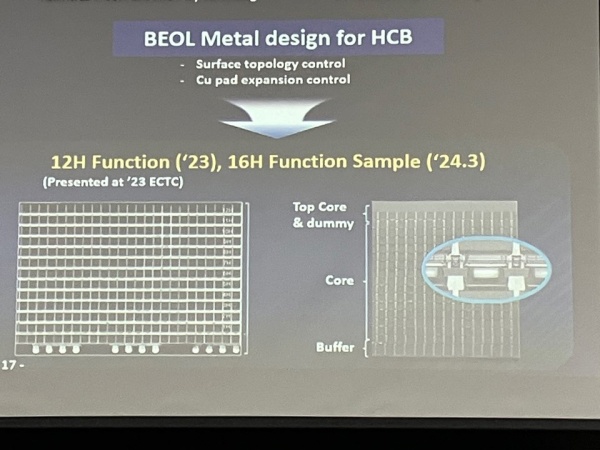
Par rapport au processus de liaison existant, la liaison hybride n'a pas besoin d'ajouter de bosses entre les couches de mémoire DRAM, mais connecte directement les couches supérieure et inférieure de cuivre au cuivre. Peut améliorer considérablement le taux de transmission du signal et est plus adapté aux exigences de bande passante élevée de l'informatique IA.
La liaison hybride peut également réduire l'espacement des couches DRAM, réduisant ainsi la hauteur totale du module HMB, mais elle est également confrontée au problème d'une maturité insuffisante et de coûts d'application coûteux.
Samsung Electronics adopte une stratégie à deux volets en termes de technologie de liaison de mémoire HBM4, développant simultanément la liaison hybride et les processus TC-NCF traditionnels.
Sur la base de l'image ci-dessous et des rapports précédents sur ce site, la limite de hauteur du module HBM4 sera assouplie à 775 microns, ce qui est propice à l'utilisation continue du TC-NCF.
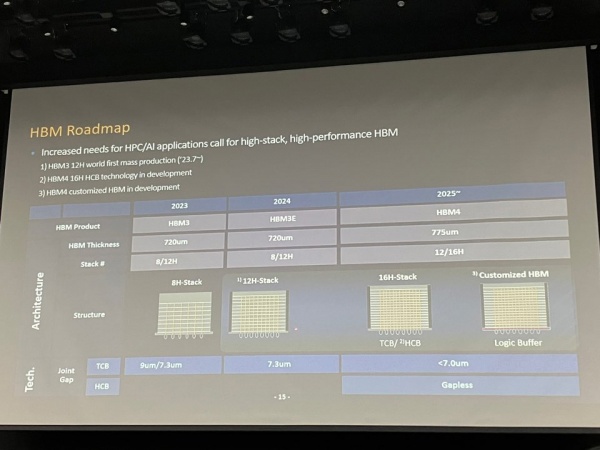
Samsung travaille dur pour réduire l'écart entre les plaquettes du processus TC-NCF, dans le but de réduire cette hauteur à moins de 7,0 microns dans HBM4.
Cette technologie fait également face à des doutes. Dae Woo Kim a riposté en affirmant que la solution de Samsung Electronics est plus adaptée aux modules à pile élevée de 12 à 16 couches que le MR-RUF du concurrent SK Hynix.
Ce qui précède est le contenu détaillé de. pour plus d'informations, suivez d'autres articles connexes sur le site Web de PHP en chinois!
Articles Liés
Voir plus- Que signifie généralement la capacité mémoire d'un micro-ordinateur ?
- Qu'est-ce que la mémoire courante
- Samsung Electronics prévoit de lancer un téléviseur OLED de 83 pouces utilisant des panneaux LG Display, qui pourrait être commercialisé en septembre
- Il est rapporté que la réduction de la production de mémoire flash NAND par Samsung Electronics, SK Hynix et d'autres sociétés « obligera l'industrie à augmenter les prix l'année prochaine ».
- 美光:HBM 内存消耗 3 倍晶圆量,明年产能基本预定完毕

