Heim >Technologie-Peripheriegeräte >IT Industrie >Quellen zufolge erwägt Intel die Einführung der DSA-Technologie, um die High NA EUV-Lithographie zu unterstützen und die Musterqualität zu verbessern
Quellen zufolge erwägt Intel die Einführung der DSA-Technologie, um die High NA EUV-Lithographie zu unterstützen und die Musterqualität zu verbessern
- WBOYWBOYWBOYWBOYWBOYWBOYWBOYWBOYWBOYWBOYWBOYWBOYWBnach vorne
- 2024-04-20 08:28:151511Durchsuche
Laut Nachrichten dieser Website vom 19. April berichteten die ausländischen Medien SemiAnalysis und The Elec, dass Intel die Einführung der gerichteten Selbstorganisations-DSA-Technologie erwägt, um künftige EUV-Lithographieknoten mit hoher NA zu unterstützen.
DSA ist eine der neuen Strukturierungstechnologien, von der man annimmt, dass sie die traditionelle Fotolithographie teilweise ersetzen kann (Anmerkung von dieser Seite: Die andere ist das Nanoimprinting NIL), bei der die molekularen Eigenschaften chimärer Copolymere zur Strukturierung genutzt werden. Im Allgemeinen wird davon ausgegangen, dass es eher zur Unterstützung der herkömmlichen Fotolithografie geeignet ist als für den eigenständigen Einsatz.
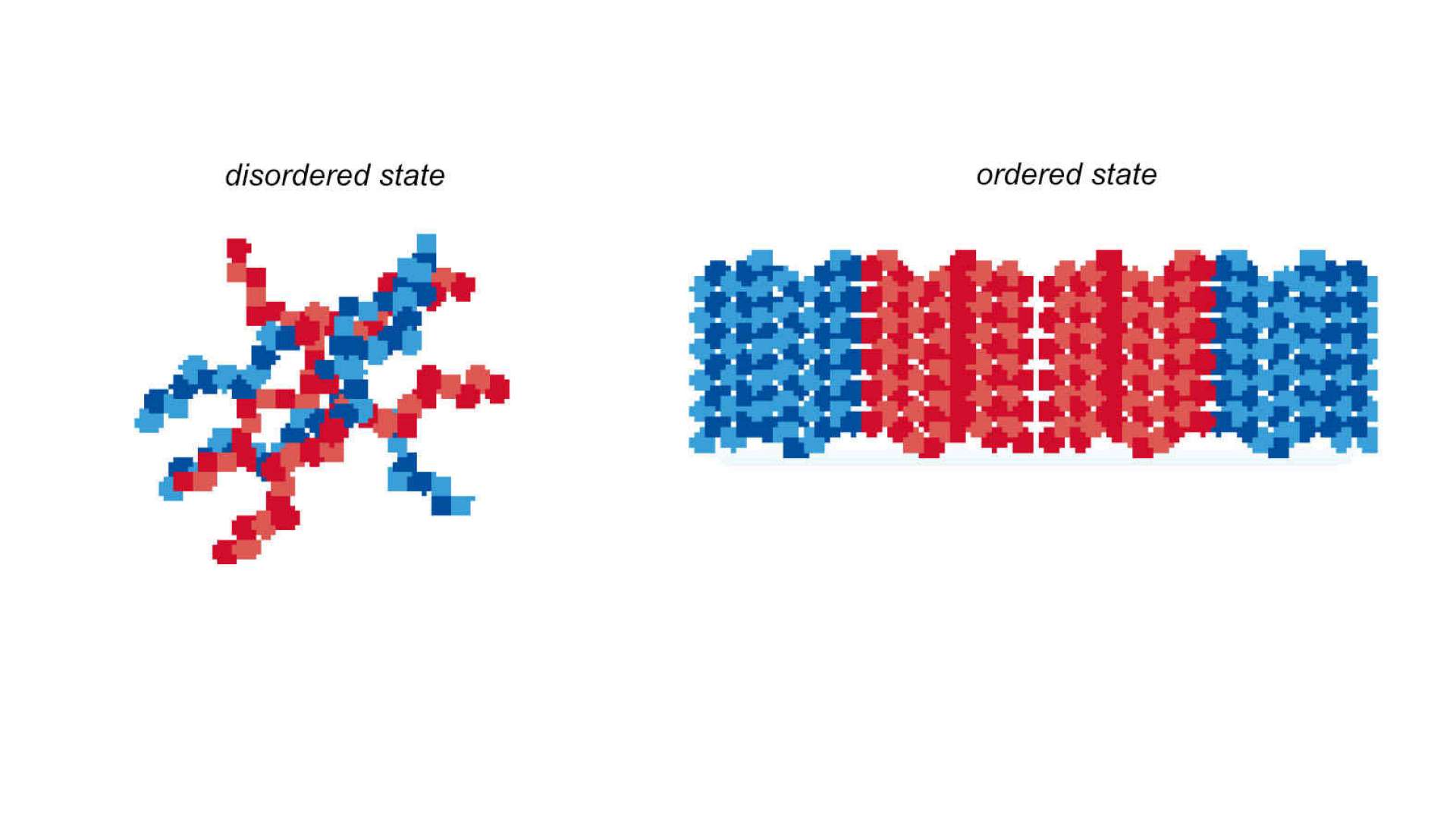
SemiAnalysis ist davon überzeugt, dass ein großes Problem bei der EUV-Lithographie mit hoher NA die Konsistenz kritischer Abmessungen ist (CD, ein Schlüsselindikator zur Messung der Komplexität von Halbleiterprozessen). Der Widerspruch zwischen der zeitlichen Bestrahlungsdosis und dem Waferdurchsatz der Fotolithographiemaschine führt zu einer Variation der CD. Um dieses Problem zu lösen, müssen eine Reihe von Maßnahmen ergriffen werden, um die Stabilität der Lithographiemaschine und die Gleichmäßigkeit der Lithographiedosis zu verbessern.
Wenn die Waferfabrik eine gute Strukturierungswirkung bei gleichzeitiger Gewährleistung kritischer Abmessungen haben muss, muss die Bestrahlungsdosis erhöht werden. Dadurch wird der Lithografieprozess verlangsamt, der Waferdurchsatz der Lithografiemaschine verringert und die Kostenbelastung der Waferfertigung erhöht.
Wenn die Fabrik die Lithografiemaschine mit einem höheren Durchsatz betreibt, bedeutet das, dass die Qualität des Lithografiemusters mit abnehmender Bestrahlungsdosis abnimmt. An diesem Punkt kann die DSA-Technologie zur gerichteten Selbstorganisation ins Spiel kommen, um Merkmalsfehler im Fotolithografiemuster zu reparieren.
Die Einführung der DSA-gerichteten Selbstorganisation kann die Qualität von Fotolithographiemustern verbessern und gleichzeitig die Bestrahlungsdosis reduzieren und den Waferdurchsatz von Fotolithographiemaschinen verbessern, wodurch die High NA EUV-Lithographie kostengünstiger wird.
Neben DSA erwägt Intel auch die Einführung der Musterformungstechnologie in die High NA EUV-Lithographie.
Applied Materials hat Anfang letzten Jahres das Musterformungssystem Centura Sculpta herausgebracht. Dieses System kann die charakteristischen Muster auf dem Wafer in einer Richtung präzise modifizieren und die Anzahl der Fotolithografievorgänge für Schlüsselschichten reduzieren. Es hat auch den Effekt, dass die Qualität der Fotolithografiemuster verbessert wird.
Samsung Electronics hat außerdem die Absicht, das Centura Sculpta-System einzuführen.
Intel-Forscher Mark Phillip betonte: „Um die Effizienz des Fotolithographieprozesses zu verbessern, ist es notwendig, andere Geräte als die Fotolithographiemaschine einzuführen, um ihn zu ergänzen.“
Das obige ist der detaillierte Inhalt vonQuellen zufolge erwägt Intel die Einführung der DSA-Technologie, um die High NA EUV-Lithographie zu unterstützen und die Musterqualität zu verbessern. Für weitere Informationen folgen Sie bitte anderen verwandten Artikeln auf der PHP chinesischen Website!

